一、HBM概述
高带宽存储器HBM(High Bandwidth Memory)是一种面向需要极高吞吐量的数据密集型应用程序的DRAM,常被用于高性能计算、网络交换及转发设备等需要高存储器带宽的领域。相较于传统GDDR,HBM具有更高速,更低耗,更轻薄等诸多优点。
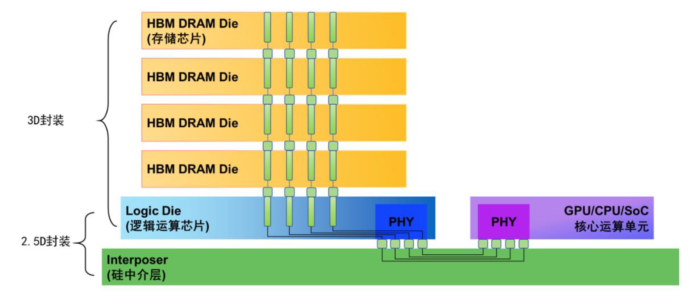 来源:天风证券
来源:天风证券
HBM包括多层DRAM芯片和一层基本逻辑芯片,不同DRAM以及逻辑芯片之间用硅通孔等技术实现通道连接,每个HBM芯片可通过多条通道与外部连接,每个通道可单独访问1组DRAM阵列,通道间访存相互独立。逻辑芯片可以控制DRAM芯片,并提供与处理器芯片连接的接口,主要包括测试逻辑模块与物理层(PHY)接口模块,其中PHY接口通过中间介质层与处理器直接连通,直接存取(DA)端口提供HBM中多层DRAM芯片的测试通道。中间介质层通过微凸块连接到封装基板,从而形成SiP系统。
 来源:华福证券
来源:华福证券
二、AI拉动HBM市场需求
目前国内外大厂争相竞逐AI大模型,而AI大模型的基础需要靠海量数据和强大算力来支撑训练和推理过程。参数量越大,AI模型越智能,GPT-4模型就有近1.76万亿参数量。对于每次重新训练的迭代,都必须从数据中心背板的磁盘上取出海量数据并进入计算盒。缩短数据存取会大大简化训练过程。在过去20年中,存储和计算并没有同步发展,硬件的峰值计算能力增加了90000倍,而内存/硬件互连带宽却只是提高了30倍。当存储的性能跟不上处理器,写入和读出的时间将是处理器运算所消耗时间的几十倍乃至几百倍,这就要打破“内存墙”,高带宽内存HBM应运而生。
HBM解决了传统GDDR遇到的“内存墙”问题,采用了存算一体的近存计算架构,不通过外部连线的方式与GPU/CPU/Soc连接,而是通过中间介质层紧凑快速地连接信号处理器芯片,极大的节省了数据传输所使用的时间与耗能。而在空间占用上,HBM采用的堆栈技术会使得在空间占用要比同比传统GDDR节省94%。在应对目前云端AI的多用户,高吞吐,低延迟,高密度部署需求所带来的计算单位需求,I/O数量也需要不断突破满足计算单位的需求。HBM工艺带来的存储器集成度极大提升,使得带宽不再受制于芯片引脚的互联数量,在一定程度上解决了I/O瓶颈,成为高算力芯片的首选。
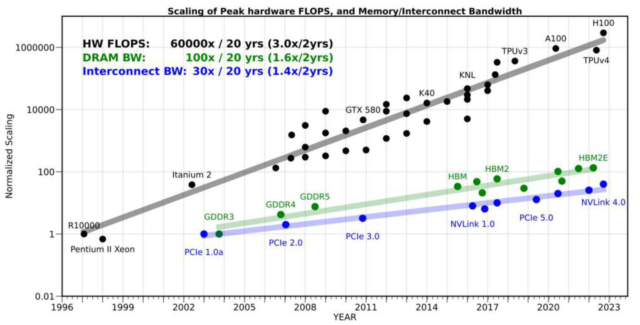
来源:国海证券
据国海证券整理,全球2023年HBM市场规模约43亿美元,2024年预计将达169亿美元,同比增长约超2.8倍。HBM单价相比传统DRAM高出数倍,预计2023-2025年HBM占DRAM总产能及总产值的比例均会大幅增长。供给方面,2023年HBM占DRAM总产能2%,HBM占DRAM总产值8%;估计2024年HBM占DRAM总产能5%,HBM占DRAM总产值21%;2025年产能占比预计将超过10%,产值占比超过30%。
HBM市场结构

来源:国海证券
三、HBM工艺
HBM生产的核心难点在于晶圆级先进封装技术,主要包括TSV(硅通孔)、micro bumping(微凸点制作)和堆叠键合。HBM首先使用TSV技术、micro bumping技术在晶圆层面上完成通孔和凸点,再通过TC-NCF、MR-MUF、Hybrid Bonding工艺完成堆叠键合,然后连接至logic die,封测公司采用CoWoS工艺将HBM、SoC通过interposer硅中介层形成互通,最终连接至基板。
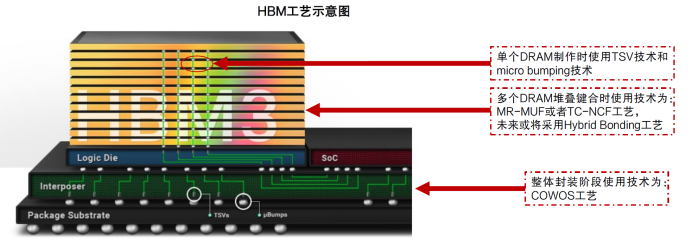
来源:华源证券
以SK海力士HBM为例,目前主要工艺:TSV、Bump、减薄、堆叠/填充、测试等环节。
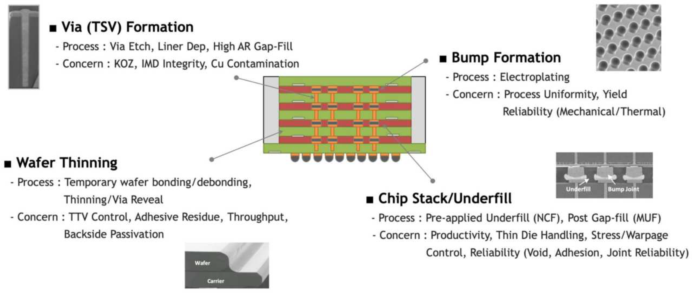
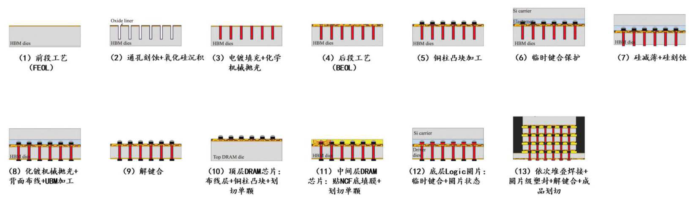
来源:SK海力士
主要工艺1.TSV
TSV是通过垂直堆叠芯片、垂直连接各层来实现信号传输的最新互连方案。为了实现信号的传输,在通孔的中心填充导电性良好的金属来实现互连。
TSV结构示意图
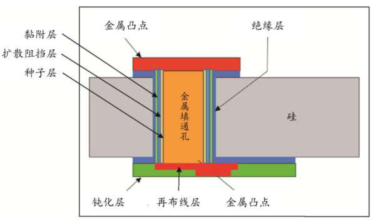
TSV基本工序

来源:国海证券
TSV相较于传统互连方式更有优势。传统方式是采取金属布线和引线键合技术相结合的方式实现互连封装,其信号传输距离长,信号损耗大,降低了通道和电路的可靠性。同时,平面层内互连布线复杂,容易导致信号和某些器件之间相互干扰。此外,平面布线也占用了芯片一定的使用面积。相较于传统方式,TSV采用垂直互联方式,其优势在于进一步提高了芯片的集成度,避免了空间的闲置和浪费,从而提高了芯片的堆叠密度。同时,由于是垂直空间互连,信号的传输效率和可靠性大大提高。硅通孔的应用使芯片的集成化、小型化和低功耗成为可能。
传统互连方式 VS TSV垂直互连示意图
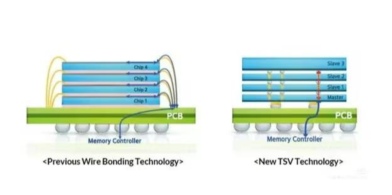
来源:华源证券
主要工艺2. 凸点
凸点(Bumping)工艺主要用于实现芯片之间的高密度电气连接,通过在晶圆上形成凸点阵列,实现芯片与基板或芯片之间的垂直互连。微凸点Microbump技术能够显著提高芯片之间的互连密度和带宽,同时减少互连长度,降低信号延迟和功耗。
焊料凸点/铜柱凸点主要生产流程
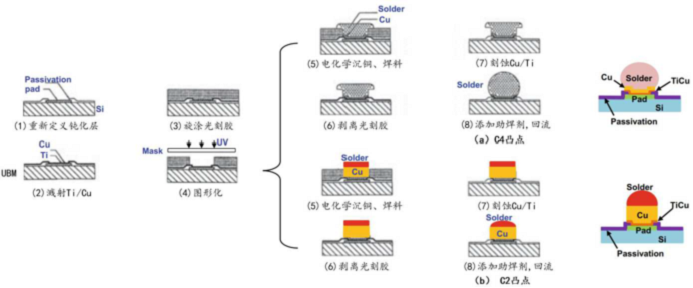
来源:国海证券
主要工艺3. 减薄
减薄:为满足TSV和三维堆叠型3D集成制造需求,减薄后晶圆厚度越来越薄,达到100μm以下。超薄晶圆的机械强度低,翘曲度高,为了解决其支撑和传输中的高碎片率问题,同时提高产品良率和性能,通常采用临时键合和解键合工艺(TBDB)。
临时键合:常用方式包括干膜、胶水两大类,主要步骤包括键合介质涂覆、前烘固化、晶圆与键合载片对准、真空热压等。
解键合:常用方式包括UV照射(针对UV干膜)、机械剥离(针对热熔胶)、热滑移剥离(针对热熔胶)和激光剥离(针对激光胶),主要步骤包括翘曲矫正、热解滑移(或其他方式剥离)、晶圆清洗等步骤。
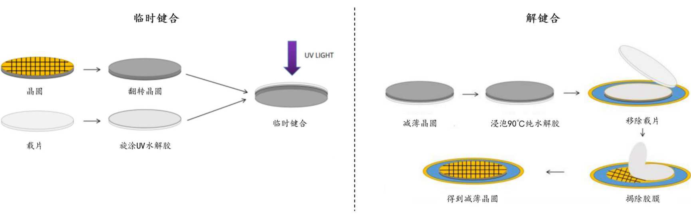
来源:《四寸砷化镓晶圆临时键合解键合工艺技术》
主要工艺4.堆叠/填充
4.1键合
热压键合(TCB)主要用于创建原子级金属键合,利用力和热促进原子在晶格间迁移,从而形成清洁、高导电性和坚固的键合。TCB可提高精度,可支持10μm甚至更小节距的键合,12堆栈HBM依然使用TCB。
此外还有混合键合,工艺条件较高,现处于起步阶段。虽然一些芯片制造商采用了混合键合,但目前工艺成本太高,无法大规模使用。混合键合对设备精度、工艺环境及表面质量等方面提出较高要求。
1)需要精准对齐并键合SiO2绝缘层与Cu接触点。
2)工艺环境需要class1 clean room。
3)待键合表面的粗糙度、晶圆翘曲度需要满足较高要求。
4)Cu-Cu键合和介质-介质键合二者常会相互干扰,需要兼顾两方面的键合要求。
5)精确控制凹陷:铜和其他金属进行CMP时,由于过度抛光以及金属和电介质的柔软度不同,经常会出现凹陷现象;因此需要控制凹陷的精确轮廓,以防止键合过程中铜过度/生长不足。
4.2底部填充
底部填充的主要作用包括分散应力、增加芯片连接的刚度和强度、改善焊点的热疲劳可靠性等作用,主要工艺包括毛细流动型底部填充(CUF)、非流动型底部填充(NUF)、模塑底部填充(MUF)。
MUF:底部填充和芯片塑封通过一个步骤实现,大幅提高生产效率,提高封装的机械强度;MUF技术实现条件包括尺寸更细小的填充粒子、优化树脂配方、在封装基板上设置排气孔等。
当前HBM实现多层DRAM互连的主要解决方案是热压非导电膜(TC-NCF)和批量回流模制底部填充(MR-MUF)。
TC-NCF:先用非导电薄膜填充DRAM die微凸点侧的微凸点空隙,再用热压键合工艺连接两层die,三星和美光主要采用该方案。
MR-MUF:结合回流和模制工艺,将芯片连接到电路上,并用液态环氧树脂模塑料(EMC)填充芯片间及凸点间的空隙。MR-MUF是SK海力士2019年推出的新型封装技术,能够有效改善芯片散热性能,同时具备速度和良率优势。
四、主要HBM厂商产品进展
目前全球HBM市场被SK海力士、三星、美光三家企业垄断,根据TrendForce集邦咨询数据,2023年市占率分别为47.5%、47.5%和5%,2024年SK海力士市占率预计增至52.5%。产能方面,HBM三大供应商均在积极扩产,TrendForce数据显示,2023年底SK海力士、三星、美光HBM总产能(含TSV)为4.5、4.5、0.3万片/月,2024年底预计增至12-12.5、13、2万片/月,但产能会根据验证进度、客户订单持续调整。

来源:TrendForce集邦咨询
2024年,海力士全球率先开始量产8/12层HBM3E,实现了现有HBM产品中最大的36GB容量。11月4日,海力士正式于2024年SKAI峰会上宣布开发全球最大容量16层堆叠HBM3E;预计HBM412hi(12层)产品将于2026年发布,而HBM416hi(16层)产品将于2027年首次亮相。

来源:TrendForce集邦咨询
SK海力士目前在探讨将该技术应用于16层以上HBM产品的必要性。同时,公司也在考虑采用先进MR-MUF技术和混合键合技术相结合的方式。
来源:华源证券